اثر فشار گاز محفظه بر نرخ لایه نشانی اسپاترینگ
عملکرد سیستمهای مگنترون اسپاترینگ معمولا با متغیرهایی همچون توان تخلیه پلاسما، اندازه میدان مغناطیسی، عمق ناحیه خوردگی کاتد و دیگر متغیرهای تکنولوژیک و مشخصات ساختاری تعریف میشود. فشار گاز در داخل محفظه خلاء هم یکی از متغیرهای موثر بر عملکرد سیستمهای مگنترون اسپاترینگ میباشد. فشار محفظه در حین لایهنشانی علاوه بر اثرگذاری بر کیفیت و خلوص لایه، در فرآیند انتقال اتمهای کندوپاش شده به زیرلایه نیز بسیار تعیین کننده است.
نرخ رشد لایه در مگنترون اسپاترینگ
واضح است که نرخ رشد لایه به طور مستقیم به تعداد اتمهایی که به زیرلایه میرسند، وابسته است. یک تخمین ساده بر اساس مدل برخورد کشسان نشان میدهد که در لایه نشانی سیلیکون به روش مگنترون اسپاترینگ، اتم سیلیکون کنده شده از سطح تارگت حدود ۹۷% انرژی خود را در یک برخورد با اتم آرگون از دست میدهد و به زیرلایه نمیرسد. در نتیجه، عمدتا اتمهای سیلیکونی که در مسیر رسیدن از سطح هدف به زیرلایه برخوردی نداشتهاند، در فرآیند رشد لایه دخالت دارند.
بنابراین، مقایسه نرخ رشد لایه با درصد اتمهای کندوپاشی پراکنده نشده توسط اتمهای موجود در محفظه معقول به نظر میرسد. در ادامه، محاسبات مربوط به پراکندگی (Scattering) ذرات هدف برای دستیابی به وابستگی نرخ رشد به فشار کار محفظه آورده شده است. داریم:
(Ns = Np K(E۰) (۱
که در اینجا Ns تعداد اتمهای کندوپاش شده در ثانیه (نرخ کندوپاش)، Np تعداد یونهای اولیه در واحد زمان و (K(E۰ ضریب کندوپاش ماده کاتد است که بستگی به انرژی یونهای گاز محفظه دارد. (K(E۰ از نظر عددی برابر است با نسبت تعداد یونهای اولیه که کاتد را بمباران میکنند به تعداد اتمهایی که در اثر بمباران یونی از کاتد بیرون میآیند و مقدار (K(E۰ نمایانگر بازده کندوپاش است. در طیف انرژیهای یونهای برخوری به کاتد (کمتر از eV 1000)، معمولا ضریب کندوپاش متناسب با انرژی یونها است.
انرژی یونهای گاز محفظه به ولتاژ تخلیه مگنترون و در نتیجه به فشار محفظه، وابسته است. بنابراین، ضریب اسپاترینگ و نرخ کندوپاش نیز وابسته به فشار کار محفظه است. تعداد یونهای اولیه Np برخوردکننده به سطح کاتد در هر ثانیه با توجه به این که تنها یونهای موجود در ناحیه تخلیه الکتریکی نزدیک کاتد، در فرآیند انتقال جریان دخیل هستند، مشخص میشود. به عبارت دیگر، Np متناسب با جریان تخلیه مگنترون است:
(Np = I/e (۲
که در رابطه (۲)، I جریان تخلیه مگنترون و e بار الکترون است.
برای توصیف انتقال (Transport) اتمهای کندوپاش شده، باید توزیع طول پویش آزاد میانگین (Mean Free Path) و پراکندگی آنها توسط اتمهای گاز محفظه را نیز در نظر گرفت. علاوه بر این، یک تخمین ساده بر اساس برخورد الاستیک نشان میدهد اگر جرم اتمهای کاتد و گاز محفظه قابل مقایسه باشد، اتم کندوپاشی مقدار زیادی از انرژی خود را در این برخورد از دست میدهد. بنابراین اتمهای بدون برخورد در انتقال انرژی به سطح زیرلایه، نقش بیشتری دارند و در اینجا مورد بررسی قرار میگیرند.
احتمال برخورد اتمهای کندوپاش شده هدف با گاز محفظه، (C(L، در صورتی که طول پویش آزاد اتمها از فاصله کاتد–زیرلایه بیشتر نباشد، با رابطه زیر داده میشود:
(C(L) = 1-exp(-L/λ) (۳
که در آن L فاصله بین کاتد–زیرلایه و λ طول پویش آزاد محاسبه شده در یک فشار مشخص با توجه به رابطه زیر است:
(λ= (k B T)/(√۲ Pg σ) (۴
که در اینجا Pg کل فشار تولید شده توسط اتمهای کندوپاشی و اتمهای گاز محفظه است، kB ثابت بولتزمن، T دما و σ سطح مقطع کل، شامل برهمکنشها، تبادل تکانه بین ذرات برخوردکننده و فرآیندهای یونیزاسیون وبرانگیختگی اتمهاست. شکل ۱ بستگی نسبت اتمهای کندوپاشی برخوردکننده در حال ترابرد در فاصله کاتد–زیرلایه در فشارهای محفظه مختلف را نمایش میدهد.

بنابراین تعداد اتمهای کندوپاشی Nf که در فشار Pg دچار برخورد میشوند برابر است با:
(Nf = I K(E۰)/e exp((√۲ Pg σL)/(kB T)) (۵
به عنوان مثال، اگر فشار محفظه از ۱.۵ به ۸.۵ میلیتور افزایش پیدا کند، با کاهش ۹۰ درصدی اتمهای کندوپاشی پراکنده نشده در فاصله کاتد–زیرلایه، نرخ رشد لایه سیلیکون حدود ۲۵% کاهش مییابد. برای مطالعه بیشتر به این مقاله میتوانید مراجعه نمایید.

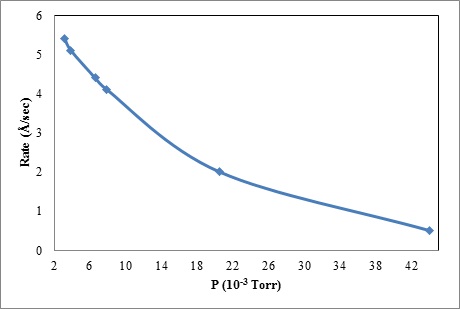
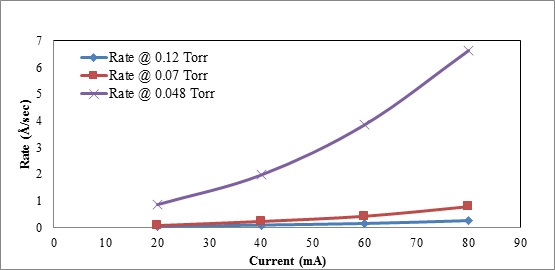
بررسی موردی لایه نشانی نقره به روش مگنترون اسپاترینگ
شرکت پوششهای نانوساختار برای لایهنشانی لایههای نازک مواد مختلف، دستگاههای لایهنشانی متنوعی با پمپ توربومولکولار دارد مانند سیستمهای لایهنشانی اسپاترینگ رومیزی خلاء بالا (DST1) و دستگاه سه کاتده (DST3) به همراه تبخیر حرارتی (DST3-T) و سیستم لایهنشان کربن (DCT) ارائه میدهد. برای اطلاعات بیشتر به سایت شرکت مراجعه نمایید.
دستگاههای مگنترون اسپاترینگ
منابع
- D.M. Mitin, A.A. Serdobintsev, Effect of Scattering of Sputtered Atoms on the Growth Rate of Films Fabricated by Magnetron Sputtering, Technical Physics Letters, 2017, Vol. ۴۳, No. ۹, pp. 814–۸۱۶.














