اسپاترینگ فرکانس رادیویی (RF) چیست؟
اسپاترینگ جریان مستقیم (DC) متداول، روشی ارزان برای لایهنشانی هدفهای فلزی رسانای جریان الکتریکی است. اما در لایهنشانی اهداف نارسانا کاربرد ندارد و نمیتوان لایه نازکی از اهداف نارسانای دیالکتریک را به روش اسپاترینگ ایجاد نمود؛ زیرا با بمباران هدف نارسانا توسط یونهای مثبت، بار الکتریکی مثبت بر روی سطح تجمع پیدا میکند و یونهای مثبت را دفع میکند که در طول زمان این امر موجب جرقهزدن داخل پلاسما و توقف فرآیند کندوپاش میشود. بنابراین برای غلبه بر نارساییهای اسپاترینگ DC در لایهنشانی اهداف نارسانای الکتریکی، از اسپاترینگ RF استفاده میشود.
تفاوت اسپاترینگ RF و DC
در اسپاترینگ RF از یک منبع تغذیه با پتانسیل الکتریکی متناوب (منبع تغذیه AC) به جای DC متصل به کاتد در محیط خلاء استفاده میشود. در این روش قطبهای مثبت و منفی منبع تغذیه AC به طور متناوب تغییر میکند، در نتیجه با قرار گرفتن هدف در قطب مثبت در نیمی از دوره تناوب، الکترونها به سمت هدف حرکت میکنند و بار مثبت جمع شده بر روی سطح را خنثی میکنند؛ و در نیمه دیگر دوره تناوب با بمباران هدف با یونهای مثبت اتمهای هدف کندوپاش شده و بر روی زیرلایه قرار گرفته و تشکیل لایه میدهند (شکل ۱ و ۲).
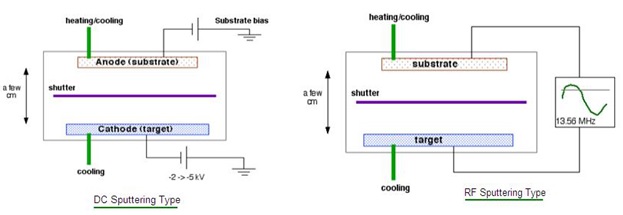
برای تخلیه الکتریکی مداوم نیاز به فرکانس MHz 1 و بالاتر است. اعمال جریان متناوب به یک هدف نارسانا در این محدوده فرکانسی معادل عبور جریان از دیالکتریک خازنهای بسته شده به صورت سری است. از آنجا که معمولا فرکانس مورد استفاده در این روش در محدوده MHz 5-30 است، این روش به عنوان اسپاترینگ فرکانس رادیویی شناخته میشود.

اصول کار اسپاترینگ RF
در اسپاترینگ RF، کاتد و آند با یک خازن مسدودکننده (C) (Blocking Capacitor) به صورت سری بسته شدهاند (شکل ۳). این خازن بخشی از یک شبکه تطبیق امپدانس (Impedance-Matching Network) است که برای بهینهسازی انتقال توان از منبع RF به پلاسما استفاده میشود. ولتاژ RF به صورت متناوب با رابطه (۱) نمایش داده می شود:

اگر دامنه ولتاژ (VRF) را در حدود ۵۰۰ ولت در نظر بگیریم (شکل ۴-a)، در صورتی که خازن مسدودکننده در مدار نباشد، جریان الکتریکی عبوری از هدف به شکل ۴-b خواهد بود. از آنجا که پتانسیل پلاسما نزدیک به پتانسیل زمین است، با تغییر علامت VRF، چگالی جریان الکترود بین Jion و qz– تغییر میکند. بنابراین جریان خالص میانگین در یک دوره تناوب صفر نخواهد بود. در صورت حضور یک ولتاژ بایاس DC، که توسط خازن مسدودکننده تأمین شده است، ولتاژ کاتد با رابطه (۲) مشخص میشود (شکل ۴-c):
Vcath(t)= VRF(t) – VDC رابطه (۲)

در بیشتر زمانها پتانسیل هدف کمتر از پلاسما است. برای دستیابی به جریان خالص صفر در هر چرخه RF، باید پتانسیل الکترود در طول مدت یک چرخه اغلب کمتر از صفر باشد. هنگامی که پتانسیل کاتد مثبت است، توسط الکترونها بمباران شده و دارای بار منفی میشود؛ از آنجا که قابلیت تحرک الکترونها بیشتر از یونهای آرگون است و سریعتر هستند، باید مدت زمان بمباران الکترونی هدف کاهش یابد و مدتی که کاتد در پتانسیل منفی است و توسط یونهای مثبت بمباران میشود افزایش پیدا کند تا بار جمع شده بر روی هدف خنثی شود (شکل ۴-d). بدین ترتیب سطح زیر نمودار جریان الکترود (معادل جریان میانگین) معادل صفر میشود.
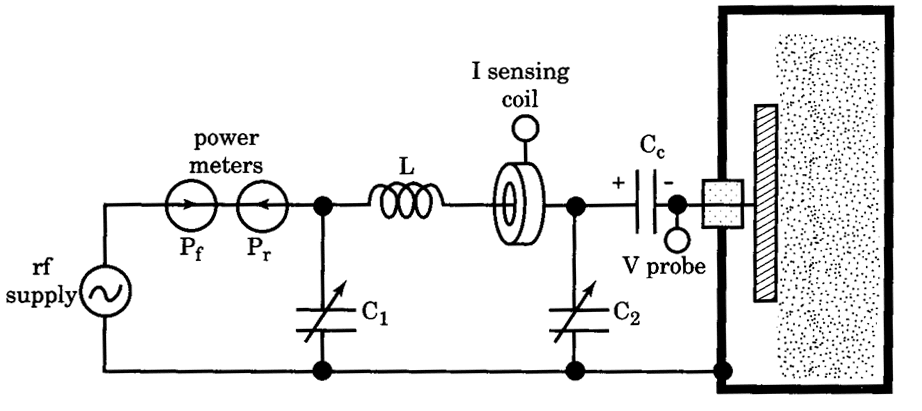
علت استفاده از فرکانس MHz ۱۳.۵۶
به منظور جلوگیری از تداخل با فرکانسهای مورد استفاده در ارتباطات رادیویی، فرکانس استاندارد رادیویی مورد استفاده در دستگاههای صنعتی (I: Industrial)، علمی (S: Scientific) و پزشکی (M:Medical)، که به عنوان باند ISM خوانده میشود، توسط متولیان ارتباطات بینالمللی بر اساس قوانین رادیویی ITU در سال ۲۰۱۲، معادل MHz 13.56 با پهنای باندKHz 14 تعیین شده است.
همچنین، این فرکانس به اندازه کافی کم هست تا فرصت کافی برای انتقال تکانه یونهای آرگون به هدف را در اختیار قرار دهد. در فرکانسهای بالاتر یونهای +Ar عملا بیتحرک شده و تنها الکترونها در فرآیند کندوپاش نقش ایجاد میکنند (مشابه روش لایهنشانی با پرتو الکترونی).
یک مشکل متداول
همانطور که قبلا ذکر شد، اهداف عایق (غیر رسانا) را نیز میتوان از طریق کندوپاش RF لایهنشانی نمود. از آنجایی که این مواد رسانای حرارتی و الکتریکی ضعیفی هستند، باید با یک ورق رسانای نازک به عنوان صفحه پشتی تقویت شوند تا از شوک حرارتی و تجمع بار روی هدف جلوگیری شود.
از طرفی، سطح هدف دیالکتریک (غیر رسانا) باید قسمت رسانا (صفحه پشتی) را که در زیر قرار دارد کاملاً بپوشاند، در غیر این صورت صفحه پشتی در معرض میدان الکتریکی قرار میگیرد و خازن دچار اتصال کوتاه میشود. در صورتی که در فرآیندهای لایهنشانی یا تمیزکردن با پلاسما و یا عملآوری سطوح دیالکتریک با پلاسما، سطح دیالکتریک کاملا سطح فلز زیرین خود را نپوشانده باشد، این مورد یکی از مشکلات متداول است.
مزایای اسپاترینگ RF
- پلاسمای تشکیل شده در این روش به جای متمرکز شدن در اطراف کاتد یا ماده هدف در تمام محفظه گسترش مییابد.
- جریان پلاسمای بیشتر در فشار کار کمتر: پلاسما در فشار کار کمتری (mTorr 1-15) میتواند تشکیل شود که منجر به برخورد کمتر اتمهای کندوپاش شده با ذرات محفظه و طول پویش آزاد بزرگتر اتمهای هدف است. همچنین توسط میدان مغناطیسی یک تونل مرزی ایجاد میشود که الکترونها را در نزدیکی سطح کاتد به دام میاندازد و نرخ لایهنشانی را در فشار کمتر افزایش میدهد.
- با از بین رفتن بارهای تجمیعی بر روی سطح کاتد امکان جرقه زدن و ایجاد مشکلات در کنترل کیفیت لایه از بین میرود. بدین ترتیب لایهنشانی یکنواختتری صورت میگیرد.
- در اسپاترینگ RF سطح بیشتری از هدف در فرآیند اسپاترینگ درگیر شده که موجب کاهش خوردگی خطی (چگونه لایه نازکهای یکنواخت با روش اسپاترینگ بسازیم؟) در سطح هدف میشود. لذا مدت زمان بیشتری پیش از پایان عمر هدف میتوان از آن استفاده نمود.
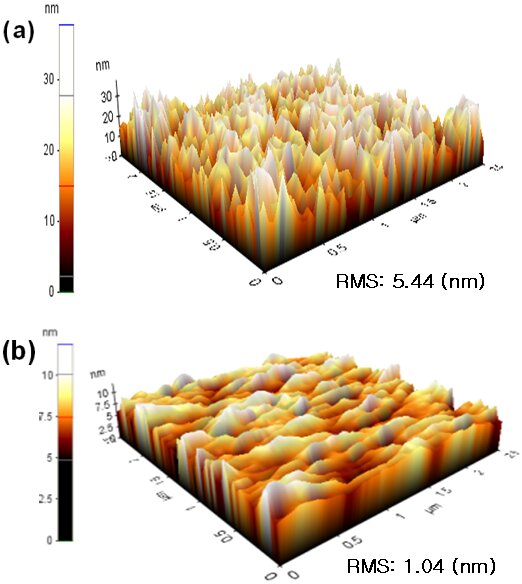
معایب اسپاترینگ RF
- برای افزایش نرخ لایهنشانی باید از ولتاژهای بالاتری نسبت به روش DC استفاده نمود، در نتیجه دمای بیشتری روی سطح زیرلایه ایجاد میکند که یکی از مشکلات این روش است.
- این روش پیچیدهتر و پرهزینهتر از روش متداول DC است.
- جریان RF بر روی سطح یا پوسته رساناها منتقل میشود، در نتیجه نیاز به اتصالات و کابلهای خاصی دارد.
- با کاهش الکترونهای ثانویه بالای کاتد، نرخ لایهنشانی نسبت به روش DC کاهش یافته و توان بالاتری برای دستیابی به نرخ لایهنشانی بیشتر مورد نیاز است که هزینهبر است.
- با توجه به اینکه RF معمولا برای اهداف نارسانا استفاده میشود و بهره اسپاترینگ این مواد نسبت به فلزات بسیار پایین است، علاوه بر پایین بودن نرخ لایهنشانی، نیاز به منبع تغذیهای با توانهای بالاتری در مقایسه با منابع تغذیه DC است.
دستگاههای اسپاترینگ RF شرکت پوششهای نانوساختار
دستگاههای اسپاترینگ شرکت پوششهای نانوساختار، که از روش اسپاترینگ برای لایه نشانی استفاده میکنند شامل مدل تک کاتده DST1-300 و مدلهای سه کاتده DST3 و DST3-T، قابلیت لایهنشانی به روش اسپاترینگ فرکانس رادیویی را دارا هستند. در این اسپاترکوترها قابلیت استفاده از منبع تغذیه W600 جریان مستقیم یا منبع تغذیه فرکانس رادیویی W300، به همراه یک مچینگ باکس اتوماتیک وجود دارد.
همچنین امکان تمیز کردن سطح زیرلایه با پلاسما یا Plasma Cleaning نیز وجود دارد. این سیستمهای لایهنشانی در خلاء با دارا بودن منابع تغذیه RF و DC امکان لایهنشانی گروه وسیعی از مواد رسانا و نارسانا، شامل فلزات (اکسیدی و غیر اکسیدی)، نیمه هادیها و سرامیکها، برای کاربردهای میکرو-نانو الکترونیک و آمادهسازی نمونههای FESEM را فراهم میآورند (SEM کوترها).
منابع
- https://www.sputtertargets.net/sputter-coating-technologies-radio-frequency-rf-sputtering.html
- https://www.sciencedirect.com/topics/materials-science/radio-frequency-sputtering
- “The Low Pressure Plasma Processing Environment” Donald M. Mattox, in Handbook of Physical Vapor Deposition (PVD) Processing (Second Edition), 2010
- https://baalkikhaal.github.io
- http://www.semicore.com/news/92-what-is-rf-sputtering
- “Improved electrochromic performance of a radio frequency magnetron sputtered NiO thin film with high optical switching speed” RSC Adv., 2016, ۶, ۷۹۶۶۸-۷۹۶۸۰, https://doi.org/10.1039/C5RA27099E
- https://www.rfwireless-world.com/Terminology/RF-sputtering-vs-DC-sputtering.html
- https://www.tn.ifn.cnr.it/facilities/rf-sputtering-facility/rf-sputtering-principles
- Park, Sang Eun, et al. “Properties of gallium-doped zinc-oxide films deposited by RF or DC magnetron sputtering with various GZO targets.” Journal of the Korean Physical Society 54.3 (2009): 1283-1287.














سلام
ممنون از مطلبتون.
آیا امکان لایهنشانی PTFE (تفلون) با استفاده از اسپاترینگ RF وجود دارد؟
بله، PTFE (تفلون) با استفاده از سیستمهای اسپاترینگ RF ساخت شرکت ما قابل لایهنشانی است. متغیرهای مورد استفاده دستگاههای مختلف ممکن است متفاوت باشد و لایهنشانی میتواند با استفاده از خلاء پایین یا بالا در فشار کار پایه لایهنشانی صورت پذیرد. معمولا به دلیل اثرات حرارتی و ذوب شدن هدف تفلون، از توان کمتر از ۲۰۰ وات در لایهنشانی استفاده میشود.
با سلام
آیا توان RF مورد نیاز برای ایجاد پلاسما در صورت استفاده از هدف متصل به صفحه پشتبند در مقایسه با هدف بدون صفحه پشتبند متفاوت است؟
با تشکر
توان RF مورد نیاز برای لایهنشانی اسپاترینگ اهداف و پلاسمای ایجاد شده به وجود یا عدم وجود اتصال به صفحه پشتبند بستگی مستقیم ندارد. اصولا اتصال به صفحه پشتبند برای خنکسازی موثر هدف در حین لایهنشانی، به منظور لایهنشانی یکنواخت و کنترلپذیر و افزایش عمر هدف انجام میشود. خنکسازی نامناسب هدف در توانهای لایهنشانی بالا، به دلیل ایجاد حرارت در هدف در حین فرآیند اسپاترینگ، منجر به ایجاد ترک در هدف میشود. معمولا به دلیل رسانش حرارتی بالای مس از آن به عنوان صفحه پشتبند استفاده میشود تا حرارت ایجاد شده در هدف در فرآیند اسپاترینگ را دفع کند.
خاصیت آبگریزی و چسبندگی لایه PTFE (تفلون) لایه نشانی شده بر روی شیشه به روش اسپاترینگ چگونه است؟
با بهینهسازی پارامترهای موثر در لایهنشانی به روش اسپاترینگ RF مانند:
نرخ و زمان لایه نشانی
ضخامت لایه
توان RF
جریان گاز آرگون
امکان لایه نشانی یک لایه نازک از تفلون بر روی زیرلایه شیشه با قابلیت آبگریزی و چسبندگی بالا وجود دارد. در صورت تمایل مطلب آبدوست و آبگریز را مطالعه نمایید.
سلام خسته نباشید
چگونه می توان لایۀ نازک Si3N4 را لایه نشانی کرد؟
سلام. سپاس.لایه نازک Si3N4 نازک Si3N4 با استفاده از کاتد آبگرد RF و منبع تغذیه RF با استفاده از توانی در حدود ۱۰۰-۲۰۰ وات به دو روش قابل لایه نشانی است:
۱- با استفاده از هدف Si و انجام لایه نشانی واکنشی اسپاترینگ RF و کنترل نسبت جریان گازهای N2 به Ar+N2.
۲- با استفاده از هدف Si3N4 (با استفاده از صفحه پشتبند ایندیوم یا الاستومر) همراه با جریان گاز Ar/N2 برای حفظ استوکیومتری لایه تشکیل شده بر روی زیرلایه.
با توجه به کاربرد لایه و ایجاد ویژگیهای مورد نیاز در لایه، ممکن است نیاز به اعمال ولتاژ بایاس و حرارتدهی زیرلایه در حین لایهنشانی باشد.
شرایط مناسب یرای لایه نشانی اهداف SiO2 و SiN چیست؟
اسپاترینگ اهداف نیمه رسانای SiO2 و Si/SiN از طریق اسپاترینگ RF یا اسپاترینگ واکنشی RF با استفاده از خطوط لوله گازهای مختلف (اکسیژن و نیتروژن) و MFC های دقیق برای کنترل استوکیومتری لایه انجام می شود.
چه مقدار توان RF می توان به اهداف نیمه رسانا اعمال کرد؟
اهداف نیمه رسانای تحت فرآیند اسپاترینگ با ولتاژ RF باید به یک صفحه پشت بند نازک فلزی متصل شوند تا در حین فرآیند لایه نشانی انتقال حرراتی بهتری بین هدف و کاتد صورت گیرد و احتمال شکستن هدف کاهش یابد. در نتیجه توان RF مورد استفاده در فرآیند لایه نشانی نباید بیشتر از ۲۰ وات بر اینچ مربع (۲۵۰ وات برای یک کاتد دو اینچی) باشد تا اتصال آسیب ببیند. مقدار توان بیشینه بر اساس انتقال حرراتی بهینه هدف به کاتد پبشنهاد می شود و در صورت لزوم باید از توان کمتر یا خمیر اتتقال دهنده حرارت استفاده نمود.
برای برطرف شدن مشکل اکسیدشدن هدف و تکرارپذیری در لایه نشانی DC اسپاترینگ هدف NiV با توان ۲۰۰ وات در محیط ۳۵% اکسیژن برای تشکیل لایه NiO چه اقداماتی می توان انجام داد؟ مدت زمان تمیزکردن هدف پیش از لایه نشانی را افزایش دهیم یا از اسپاترینگ RF استفاده نماییم؟
اکسید شدن هدف می تواند به دلیل توان بالای اعمال شده به هدف در حضور محیط حاوی اکسیژن باشد. اسپاترینگ RF می تواند در توان پایینتری لایه نشانی را انجام دهد تا در حین لایه نشانی دمای هدف کمتر افزایش یابد و در لایه نشانی اهداف نارسانا مناسب است. برای مطالعه بیشتردراین زمینه به صفحه وبلاگ ما مراجعه فرمایید.